Código QR

Produtos
Contate-nos

Telefone

Fax
+86-579-87223657

E-mail

Endereço
Wangda Road, Ziyang Street, condado de Wuyi, cidade de Jinhua, província de Zhejiang, China
Os substratos de carboneto de silício têm muitos defeitos e não podem ser processados diretamente. Um filme fino de cristal único específico precisa ser cultivado neles através de um processo epitaxial para fazer bolachas de chip. Este filme fino é a camada epitaxial. Quase todos os dispositivos de carboneto de silício são realizados em materiais epitaxiais. Os materiais epitaxiais homogêneos de carboneto de silício de alta qualidade são a base para o desenvolvimento de dispositivos de carboneto de silício. O desempenho dos materiais epitaxiais determina diretamente a realização do desempenho dos dispositivos de carboneto de silício.
Os dispositivos de carboneto de silício de alta e alta confiabilidade apresentaram requisitos mais rigorosos na morfologia da superfície, densidade de defeitos, dopagem e uniformidade da espessura dos materiais epitaxiais. Densidade de baixo tamanho, de baixa defeito e alta uniformidadeEpitaxia de carboneto de silíciotornou -se a chave para o desenvolvimento da indústria de carbonetos de silício.
A preparação de alta qualidadeEpitaxia de carboneto de silíciorequer processos e equipamentos avançados. O método de crescimento epitaxial de carboneto de silício mais amplamente utilizado é a deposição de vapor químico (DCV), que tem as vantagens do controle preciso da espessura do filme epitaxial e da concentração de doping, menos defeitos, taxa de crescimento moderada e controle automático de processos. É uma tecnologia confiável que foi comercializada com sucesso.
O epitaxia CVD de carboneto de silício geralmente usa o equipamento de CVD de parede quente ou de parede quente, que garante a continuação da camada epitaxial 4H cristal SiC sob condições de temperatura de crescimento mais altas (1500-1700 ℃). Após anos de desenvolvimento, a parede quente ou a CVD da parede quente pode ser dividida em reatores de estrutura horizontal horizontal e reatores verticais da estrutura vertical de acordo com a relação entre a direção do fluxo de gás de entrada e a superfície do substrato.
A qualidade do forno epitaxial de carboneto de silício possui principalmente três indicadores. O primeiro é o desempenho do crescimento epitaxial, incluindo uniformidade de espessura, uniformidade doping, taxa de defeitos e taxa de crescimento; O segundo é o desempenho da temperatura do próprio equipamento, incluindo taxa de aquecimento/resfriamento, temperatura máxima, uniformidade da temperatura; e, finalmente, o desempenho do custo do próprio equipamento, incluindo o preço unitário e a capacidade de produção.
CVD horizontal de parede quente, CVD planetária de parede quente e CVD vertical de parede quase quente são as soluções de tecnologia de equipamentos epitaxiais principais que foram aplicados comercialmente nesse estágio. Os três equipamentos técnicos também têm suas próprias características e podem ser selecionadas de acordo com as necessidades. O diagrama de estrutura é mostrado na figura abaixo:

O sistema CVD horizontal da parede quente é geralmente um sistema de crescimento de grande porte de uma sólida, acionada pela flotação e rotação de ar. É fácil alcançar bons indicadores de inauguração. O modelo representativo é a PE1O6 da LPE Company na Itália. Esta máquina pode realizar o carregamento e descarregamento automáticos de bolachas a 900 ℃. Os principais recursos são alta taxa de crescimento, ciclo epitaxial curto, boa consistência dentro da bolacha e entre fornos, etc. Ele tem a maior participação de mercado na China.

De acordo com relatórios oficiais do LPE, combinados com o uso dos principais usuários, os produtos epitaxiais de 100-150 mm (4-6 polegadas) 4H-SIC com uma espessura inferior a 30 μm produzidos pela fórmula epitaxial de pó não pode ser atingida de forma seguinte: Intra-Wafer de espessura não-dominiva, não-dinâmica, o Intra-Wafer de espessura não-renifestidade, que não se pode obter, o Intra-Wafer de espessura de Intra-Wafer, que não-dina, a inteniformidade não-usina. ≤1cm-2, área sem defeito da superfície (célula unitária de 2 mm × 2mm) ≥90%.
Empresas domésticas como JSG, CETC 48, Naura e NASO desenvolveram equipamentos epitaxiais monolíticos de carboneto de silício com funções semelhantes e alcançaram remessas em larga escala. Por exemplo, em fevereiro de 2023, a JSG lançou um equipamento epitaxial SIC de 6 polegadas de 6 polegadas. O equipamento utiliza as camadas superior e inferior das camadas superior e inferior das partes de grafite da câmara de reação para cultivar duas bolachas epitaxiais em um único forno, e os gases de processo superior e inferior podem ser regulados separadamente, com uma diferença de temperatura de ≤5 ° C, que efetivamente compõe a desadachos por insuficiência de ≤5 ° C.Peças de meia -lua de revestimento sic. Estamos fornecendo peças de meia -lua de 6 polegadas e 8 polegadas para os usuários.

O sistema CVD planetário de parede quente, com um arranjo planetário da base, é caracterizado pelo crescimento de várias bolachas em um único forno e alta eficiência de saída. Os modelos representativos são os equipamentos epitaxiais de AIXG5WWC (8x150mm) e G10-SIC (9 × 150mm ou 6 × 200mm) de Aixtron da Alemanha.
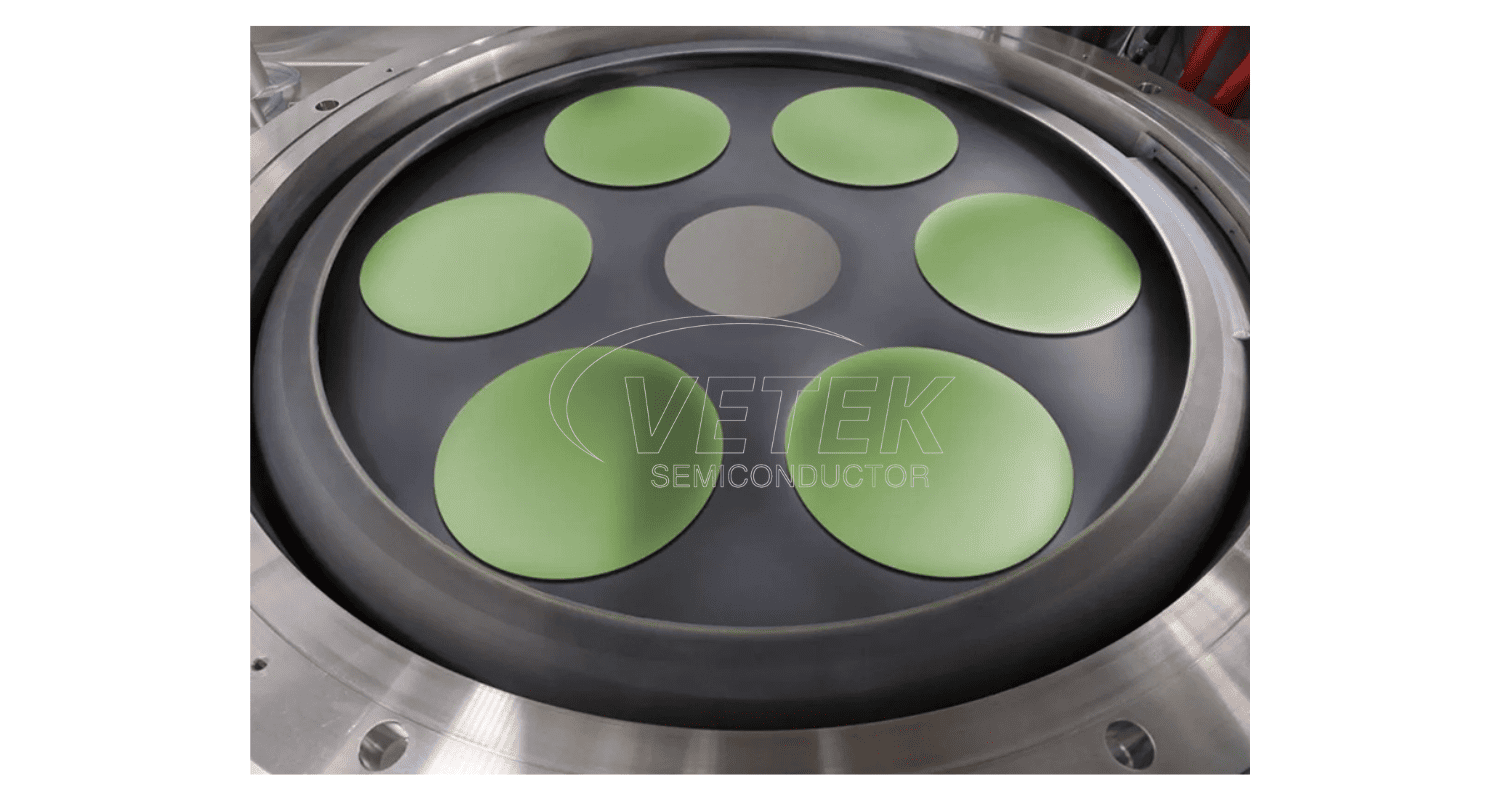
According to Aixtron's official report, the 6-inch 4H-SiC epitaxial wafer products with a thickness of 10μm produced by the G10 epitaxial furnace can stably achieve the following indicators: inter-wafer epitaxial thickness deviation of ±2.5%, intra-wafer epitaxial thickness non-uniformity of 2%, inter-wafer doping concentration deviation of ±5%, intra-wafer doping não uniformidade da concentração <2%.
Até agora, esse tipo de modelo raramente é usado pelos usuários domésticos, e os dados de produção em lote são insuficientes, o que, até certo ponto, restringe seu aplicativo de engenharia. Além disso, devido às altas barreiras técnicas de fornos epitaxiais de várias tendência em termos de campo de temperatura e controle de campo de fluxo, o desenvolvimento de equipamentos domésticos semelhantes ainda está no estágio de pesquisa e desenvolvimento e não há modelo alternativo.
O sistema CVD vertical de parede quase quente gira principalmente em alta velocidade através da assistência mecânica externa. Sua característica é que a espessura da camada viscosa seja efetivamente reduzida por uma menor pressão da câmara de reação, aumentando assim a taxa de crescimento epitaxial. Ao mesmo tempo, sua câmara de reação não possui uma parede superior na qual as partículas SiC podem ser depositadas e não é fácil produzir objetos em queda. Tem uma vantagem inerente ao controle de defeitos. Os modelos representativos são os fornos epitaxiais de uma única lança e epirevos6 e epirevos8 da nuflare do Japão.
De acordo com o Nuflare, a taxa de crescimento do dispositivo epirevo6 pode atingir mais de 50μm/h, e a densidade de defeito da superfície da wafer epitaxial pode ser controlada abaixo de 0,1cm -²; Em termos de controle de uniformidade, o engenheiro da nuflare, Yoshiaki Daigo, relatou os resultados da uniformidade intra-deslocação de uma bolsa epitaxial de 10 μm de 6 polegadas crescida usando o epirevo6, e a espessura intra-iDer e a concentração de doping não uniformiza 1% e 2,6%, respectivamente.Cilindro de grafite superior.
Atualmente, fabricantes de equipamentos domésticos, como a terceira geração e o JSG, projetaram e lançaram equipamentos epitaxiais com funções semelhantes, mas não foram usadas em larga escala.
Em geral, os três tipos de equipamentos têm suas próprias características e ocupam uma certa participação de mercado em diferentes necessidades de aplicativos:
A estrutura CVD horizontal da parede quente apresenta taxa de crescimento ultra-rápida, qualidade e uniformidade, operação e manutenção simples de equipamentos e aplicações maduras de produção em larga escala. No entanto, devido ao tipo e manutenção frequente, a eficiência da produção é baixa; A DCV planetária de parede quente geralmente adota uma estrutura de bandeja de 6 (peças) × 100 mm (4 polegadas) ou 8 (peça) × 150 mm (6 polegadas), o que melhora bastante a eficiência da produção do equipamento em termos de capacidade de produção, mas é difícil controlar a consistência das peças múltiplas e o rendimento da produção é o maior problema; A CVD vertical de parede quase quente possui uma estrutura complexa, e o controle de defeito da qualidade da produção de wafer epitaxial é excelente, o que requer manutenção de equipamentos extremamente ricos e experiência de uso.
Taxa de crescimento rápido
simples estrutura de equipamentos e
Manutenção conveniente
Grande capacidade de produção
alta eficiência de produção
Bom controle de defeito do produto
Câmara de reação longa
Ciclo de manutenção
Estrutura complexa
difícil de controlar
consistência do produto
Estrutura de equipamentos complexos,
Manutenção difícil
Representante
equipamento
Fabricantes
CVD horizontal de parede quente
CWD planetária de parede quente
CTD vertical de parede quase quente
Vantagens
Desvantagens
Ciclo de manutenção curto
Itália LPE, Japão Tel
Alemanha Aixtron
Nuflare do Japão
Com o desenvolvimento contínuo do setor, esses três tipos de equipamentos serão otimizados e atualizados iterativamente em termos de estrutura, e a configuração do equipamento se tornará cada vez mais perfeita, desempenhando um papel importante na correspondência das especificações das bolachas epitaxiais com diferentes espessuras e requisitos de defeito.



+86-579-87223657


Wangda Road, Ziyang Street, condado de Wuyi, cidade de Jinhua, província de Zhejiang, China
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Todos os direitos reservados.
Links | Sitemap | RSS | XML | política de Privacidade |
